長年の実績と信頼が生きるトランスファ方式と、今後のパネルや
薄型化への対応に応えるコンプレッション方式
テクノロジー

長年の実績と信頼が生きるトランスファ方式と、今後のパネルや
薄型化への対応に応えるコンプレッション方式
半導体の樹脂封止技術には、大きく分けてトランスファとコンプレッション、2つの方式があります。当社は、世に先駆けてマルチプランジャでの全自動半導体樹脂封止装置を開発し、業界標準を確立して以来、半導体モールディング市場において、リーディングカンパニーであり続けています。長年の実績を誇るトランスファ方式に加え、最先端封止技術として新たに開発したコンプレッション方式で、市場のニーズを先取りしたモールドプロセスをご提案しています。
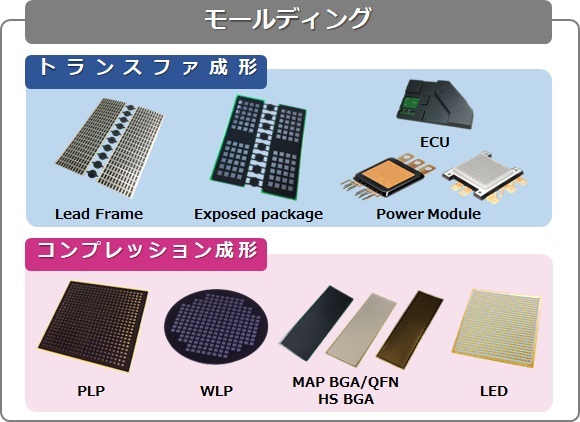
トランスファ方式とコンプレッション方式によるモールディング
トランスファ方式のモールディングは、従来より半導体など電子部品の樹脂封止に用いられてきた成形方式で、プランジャ内で一旦溶融した樹脂をキャビティに充填し硬化させる樹脂封止方法です。
キャビティに樹脂を注入する際、複数の穴から樹脂を供給するマルチプランジャ方式は、当社が草創期に開発した成形方式で、樹脂使用効率の大幅な改善と成形品質の飛躍的な向上に加え、樹脂成形サイクルを大幅に短縮することが可能となり、世界中から高く評価されました。
デファクトスタンダードともなった当社のトランスファ方式のモールディングに対する信頼性と実績から、今日まで多数の製品に採用され、そのノウハウの蓄積はお客様への最適なソリューションの提供に生かされています。
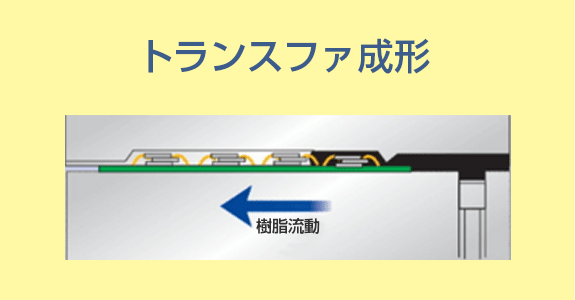
樹脂をキャビティ内に射出する成形方法

キャビティ内の樹脂を圧着させる流動が発生しない成形方法
IoT(モノのインターネット)や自動車の自動運転、データ量の増大に伴うデータセンターの増設など半導体需要が増加する中、タブレットやスマートフォンなどデバイスも多様化しています。
半導体のパッケージ技術にも薄型化・高集積化への対応が求められており、パッケージの最小化・極薄化を実現するため基板を省いてモールドするウェハレベルパッケージや高生産性・コスト低減を実現する成形プロセスが望まれています。
当社では、いち早く市場のニーズに応えるべくコンプレッション方式による新たな成形技術を開発しました。
樹脂効率100%で材料コストを削減
コンプレッション方式は、キャビティに直接、液状もしくは顆粒状の樹脂を入れ、溶融した後にワークを浸し入れて樹脂成形する樹脂封止方法です。
トランスファ方式におけるゲートやランナなどが不要になり、樹脂の使用効率はほぼ100%となります。お客様のコスト削減に大きく貢献するとともに、廃棄量の低減にもつながるため、これまで以上に環境に配慮した成形技術といえます。
樹脂流動がなくワイヤの細線化が可能
コンプレッション方式のモールディングは、樹脂の流動がほとんどなく、チップやワイヤへの影響を最小限に抑えることが可能です。パッケージ製品の成形性の向上と、ワイヤの細線化などによる材料コストの低減が図れます。
パネルサイズやウェハサイズなど大判化に対応
半導体パッケージのコスト低減を図るため、リードフレームや基板サイズの大判化が進み、それに対応した半導体製造装置が求められています。
当社のコンプレッション技術を用いることで、超大判パネル成形を可能にし、業界のコスト削減ニーズに先行したソリューションを提供しています。
フェイスダウン方式を採用
半導体パッケージの薄型化より、モールド面積が大判なパネルやウェハにも薄く均一に樹脂を供給する必要があります。当社はフェイスダウン方式を採用することにより、モールド面積の大型化に対しても、均一かつ極薄なモールドを実現しています。またフェイスアップ方式に比べ、成形時に発生する反りが少なく優位性が認められています。
製造プロセスの短縮とクリーニングレスを実現
モールディング後のバックバラインディングやCMP(化学機械研磨)などの工程が必要ないため、製造プロセス全体の時間を短縮できます。
また、離型フィルムを用いることで金型のクリーニングレスを実現しています。
当社のコンプレッション方式による成形技術は、ワークにかかる圧力も低減することができるため、Low-k材料の製品に対するモールディングにも有効です。
3D NANDフラッシュメモリやアプリケーションプロセッサ、指紋センサー、パワーデバイスなどの製品が伸びを見せており、それに適合したコンプレッション方式は品質の安定と生産性を両立した装置として世界の市場から高い評価を得ています。

当社のフェイスダウン方式のメリット
| フェイスダウン | フェイスアップ | |
|---|---|---|
| 樹脂流動性 | ◯ | ✕ |
| チップシフト | ◯ | △ |
| 真空度 | ◯ | △ |
| SIP製品 | ◯ | ✕ |
| フィラー分離(反りの要因) | ◯ | △ |
半導体モールディング装置分野においてリーディングカンパニーである当社は、長年実績のあるトランスファ方式と樹脂流動が少ない高品質なコンプレッション方式の装置・金型を提供しています。
長年培ってきた切断技術に、高速なハンドリング技術や画像解析技術を結合して、高い品質で製品を個片化する装置を提供しています。
半導体等電子部品の樹脂封止技術のリーディングカンパニーとして数々の超精密金型を市場に供給しお客様から高い評価を得ています。
超精密金型製造で培った技術により生まれた当社エンドミル、ドリルは、高精度、耐摩耗性に優れ、長寿命を実現できる製品です。