进行高精度、高速的产品切割
OUR COMMITMENT TO TECHNOLOGIES
专注于技术

切割分选技术
切割分选是半导体制造后段工序中的核心技术之一,是本公司从1990年代就开始专研的技术。现在,本公司将长年积累的切割技术与高速搬送技术及图像解析技术相结合,为客户提供可高品质的切割分选设备。

- 切割、分选等主要功能全都自主开发
- 致力于提高切割精度与搬运的高速化,提高生产效率
- 迅速应对产品小型化与基板大型化等的趋势
主要功能均自主开发
切割分选是半导体制造后段工序的核心之一。将塑封后的基板分割成单颗产品,通过分选机构把产品收纳于托盘内。
全球的第一台切割一体机就由本公司所开发。其后又通过切割机与分选机的自主开发,为市场供应专业的半导体封装器件的切割分选系统。
对应基板的翘曲问题
承担产品切割功能的切割引擎,对于如何应对因塑封成形时的树脂收缩以及切割时温度变化至关重要。能有效对应基板翘曲,且切割精度高,极大地提高了产品的成品率。自主开发切割引擎,始终致力于提供适合不同客户不同产品的切割对应方法的研发与改善。
分选是设备的另一项重要功能,它同样浓缩了本公司长年积累的技术,分选的高产出为客户提高生产效率作出了贡献。
应对产品的小型化与基板的大型化趋势
近年来,市场除了降低生产成本外,对产品的小型化与轻薄化的需求紧迫。本公司所推出的设备并非属于难以控制成本的Tape Saw而是Jog Saw,采用真空泵吸附方式进行切割,最小可对应1mm X 1mm的小型化产品。为让吸附治具对应小型产品。
今后,随着塑封基板尺寸的进一步增大,对切割机切割台旋转控制的精度要求会越来越高。对于此类难题,由本公司自主研发的切割引擎能及时而灵活地对应。
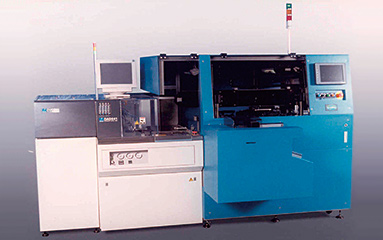
第一代切割分选一体设备
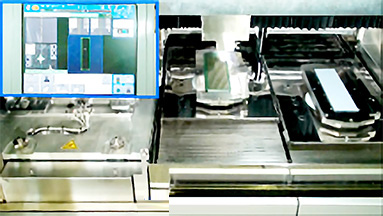
定位 (根据不同的产品选择最佳的切割位置)
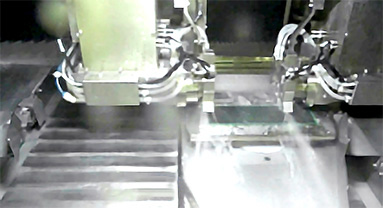
切割引擎 (利用刀具对切割台上的基板进行切割)
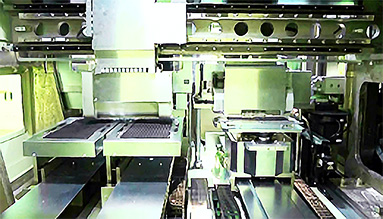
分选机 (将产品收纳至托盘)





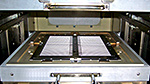









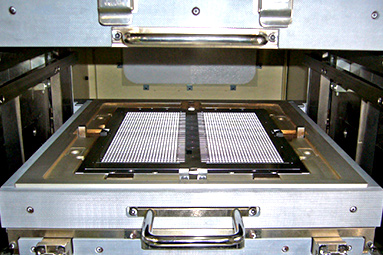






 源于京都 走向世界
源于京都 走向世界
