오랜 세월에 걸쳐 축적해온 실적과 신뢰의 결정체인 트랜스퍼 방식과 앞으로의 패널과 박형화에 대응 가능한 컴프레션 방식
OUR COMMITMENT TO TECHNOLOGIES
기술에 대한 중점사항

수지성형 기술 /
트랜스퍼 몰드・컴프레션 몰드
반도체 수지 밀봉 기술에는 크게 트랜스퍼와 컴프레션, 2가지 방식이 있습니다. 당사는, 세상에 최초로 멀티 프런져로 전자동 반도체 수지 밀봉 장치를 개발하는 업계 표준을 확립한 이후 반도체 몰딩 시장에서 선도 기업 입지을 계속해서이어 가고 있습니다.오랜 실적을 자랑하는 트랜스퍼방식과 함께 최첨단 밀봉 기술로서 새로 개발한 컴프레션 방식으로 시장의 수요를 선점한 몰드 프로세스를 제시하고 있습니다.
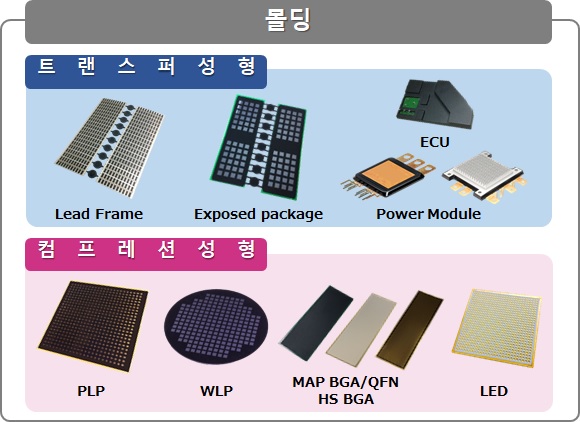
트랜스퍼 방식과 컴프레션 방식의 몰딩
트랜스퍼 방식
트랜스퍼 방식의 몰딩은 이전부터 반도체 등 전자 부품의 수지 밀봉에 이용되여 왔다 성형 방식으로 프런져 내에서 일단 용융된 수지를 캐비티에 주입하고 경화시키는 수지 밀봉 방식입니다.
캐비티에 수지를 주입할 때 복수의 구멍으로 수지를 공급하는 멀티 플런저 방식은 당사가 초창기에 개발한 성형 방식으로 수지 사용 효율의 대폭적인 개선과 성형 품질의 비약적 향상과 함께 수지 성형 사이클을 대폭 단축할 수 있게 되어 전 세계에서 높이 평가되었습니다.
디팩토 스탠다드된 당사의 트랜스퍼 방식의 몰딩에 대한 신뢰성과 실적에서 오늘까지 다수의 제품에 채용되어 그 노하우의 축적은 고객에게 최적의 솔루션의 제공에 활용되고 있습니다.

트랜스퍼 방식 몰딩

컴프레션 방식의 몰딩
컴프레션 방식
IoT(물건의 인터넷)이나 자동차의 자동 운전, 데이터량의 증대에 따른 데이터 센터 증설 등 반도체 수요가 증가하는 가운데, 태블릿과 스마트 폰 등 디바이스도 다양화되고 있습니다.
반도체 패키지 기술에도 평판화·고집적화에 대한 대응이 요구되며 패키지의 최소화,박형화을 실현하기 위해 기판을 생략하고 몰드 하는 웨이퍼 수준 패키지나 고생산성 및 비용 저감을 실현함 프로세스가 요구되고 있습니다.
당사에서는 재빨리 시장의 요구에 부응하도록 컴프레션 방식에 의한 새로운 성형 기술을 개발했습니다.
수지 효율 100%로 자재 비용을 삭감
컴프레션 방식은 캐비티에 직접 수지를 주입해 용융시킨 후 워크를 넣어서 수지를 성형하는 수지 밀봉 방식입니다.
트랜스 방식에서의 게이트 및 런너 등이 불필요하게 되어, 수지의 사용 효율은 거의 100%입니다.고객의 비용 삭감에 기여하고, 폐기량 저감에도 이어지기 때문에 지금까지 이상으로 환경을 배려한 성형 기술입니다.
수지 유동이 없는 와이어 세선화가 가능
컴프레션 방식의 몰딩은 수지의 유동이 거의 없어 칩이나 와이어에 대한 영향을 최소한으로 억제할 수 있습니다.패키지 제품의 성형성의 향상과 와이어 세선화 등에 의한 재료 원가 저감을 도모할 수 있습니다.
패널 크기와 웨이퍼 사이즈 등 대형화에 대응
반도체 패키지의 비용 절감을 위하여 리드 프레임이나 기판 크기의 대형화가 진행되어, 그것에 대응한 반도체 제조 장치가 요구되고 있습니다.
당사의 컴프레션 기술을 이용함으로써 초대형 패널 성형이 가능하도록 만들어 업계의 코스트 삭감 요구에 선행한 솔루션을 제공하고 있습니다.
페이스 다운 방식을 채용
반도체 패키지의 박형화에 의해 몰드 면적이 대부분인 패널 및 웨이퍼에도 얇고 균일하게 수지를 공급할 필요가 있습니다. 당사는 페이스 다운 방식을 채용하는 몰드 면적의 대형화에 대해서도 고르고 얇은 몰드를 실현하고 있습니다.또 페이스 업 방식보다, 성형시에 발생하는 워페이지이 적은 우위성이 인정되고 있습니다.
제조 프로세스의 단축과 클리닝레스를 실현
몰딩 후 백그라인딩 및 CMP(화학 기계 연마)등의 공정이 필요 없어, 제조 프로세스 전체 시간을 단축할 수 있습니다.
또 리형 필름을 이용하는 것에서 금형의 클리닝레스을 실현하고 있습니다.
당사의 컴프레션 방식에 의한 성형 기술은 워크에 가해지는 압력도 저감할 수 있어 Low-k자재 제품에 대한 몰딩에도 유효합니다.
3D NAND플래시 메모리나 애플리케이션 프로세서, 지문 센서, 파워 디바이스 등의 제품이 늘었고 그것에 적합한 컴프레션 방식은 품질 안정과 생산성을 양립한 장치로서 세계 시장에서 높은 평가를 얻고 있습니다.

당사 페이스 다운 방식의 장점
| 페이스 다운 | 페이스 업 | |
|---|---|---|
| 수지 유동성 | ◯ | ✕ |
| 칩 시프트 | ◯ | △ |
| 진공도 | ◯ | △ |
| SIP 제품 | ◯ | ✕ |
| 필러 분리(휨 요인) | ◯ | △ |
제품 목록
-
반도체 몰딩 장치 분야에서 일류 기업인 당사는 오랜기간 실적이 있는 트랜스퍼 방식과 수지 유동이 적은 고품질인 컴프레션 방식의 장치・금형을 제공하고 있습니다.
-
오랜기간 쌓아온 절단 기술에, 고속 핸들링 기술과 화상 해석기술을 결합하여 높은 품질로 제품을 개편화 하는 장치를 제공하고 있습니다.
-
반도체 등 전자부품의 수지 패키징 기술 분야를 선도하는 기업으로서 다양한 초정밀 금형을 시장에 공급하여 고객으로부터 높은 평가를 받고 있습니다.
-
초정밀 금형 제조를 통해 발전시켜 온 기술에서 탄생한 당사의 CBN 엔드밀은 높은 정밀도, 뛰어난 내마모성, 긴 수명을 모두 만족시키는 제품입니다.





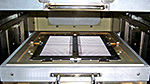









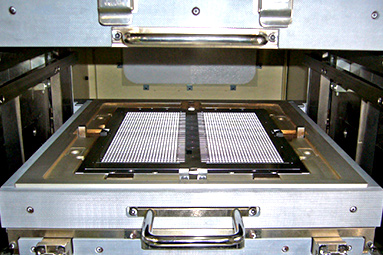






 교토에서 세계로
교토에서 세계로
