


|
PICK UP |
Advanced Package |
PICK UP
Advanced Package
|
WLP/PLP Process |
|||
|
|
As package sizes increase, migration from 300 mm wafers to panel sizes in the □300 mm class has progressed. |
||
|
New Development |
||||
|
By utilizing lasers for high-speed dicing, this technology supports cutting of irregular-shaped products combining straight and curved lines as well as high-density mounted products. The non-contact, consumable-free processing avoids use of water or grinding wheels, contributing to high quality and high productivity. |
|
|||
|
MOLDING From □500–600 mm class packages for advanced packaging to □700 mm and larger next-generation ultra-large packages. We propose molding solutions for a wide range of packages including mobile application processors, communication memories, and automotive power semiconductors, IPMs, and ECUs. |
SINGULATION The laser and blade methods realize high-precision cutting for various package sizes and mounted substrates. We propose products that support diverse shapes, including half-cut and pre-cut warp correction equipment. |
|
LASER TOWA Laser Front Co., Ltd. introduces laser-based processing technologies such as wafer marking, cutting, trimming, and welding. |
SERVICE TOWATEC Co., Ltd. introduces a multi-faceted support system that sustains equipment lifecycles, including used equipment sales and purchase, equipment refurbishment, and scheduled maintenance. |
WLP/PLP Process
Total Solution
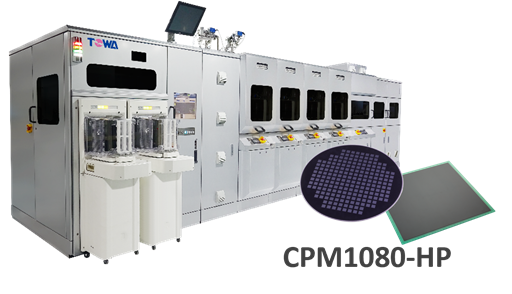
As package sizes increase, migration from 300 mm wafers to panel sizes in the □300 mm class has progressed.
While anticipating ultralarge formats, staged panelization that emphasizes feasibility and yield is becoming mainstream.
In response to these trends, TOWA proposes systems optimized for molding and cutting processes.
New Development
Laser Singulation Technology

By utilizing lasers for high-speed dicing, this technology supports cutting of irregular-shaped products combining straight and curved lines as well as high-density mounted products. The non-contact, consumable-free processing avoids use of water or grinding wheels, contributing to high quality and high productivity.
While anticipating ultralarge formats, staged panelization that emphasizes feasibility and yield is becoming mainstream.
In response to these trends, TOWA proposes systems optimized for molding and cutting processes.
MOLDING
From □500–600 mm class packages for advanced packaging to □700 mm and larger next-generation ultra-large packages. We propose molding solutions for a wide range of packages including mobile application processors, communication memories, and automotive power semiconductors, IPMs, and ECUs.
SINGULATION
The laser and blade methods realize high-precision cutting for various package sizes and mounted substrates. We propose products that support diverse shapes, including half-cut and pre-cut warp correction equipment.
LASER
TOWA Laser Front Co., Ltd. introduces laser-based processing technologies such as wafer marking, cutting, trimming, and welding.
SERVICE
TOWATEC Co., Ltd. introduces a multi-faceted support system that sustains equipment lifecycles, including used equipment sales and purchase, equipment refurbishment, and scheduled maintenance.


